服务热线


一、CMP到底是干嘛的?为什么半导体离不开它?
CMP = Chemical Mechanical Polishing(化学机械抛光),也叫化学机械平坦化。
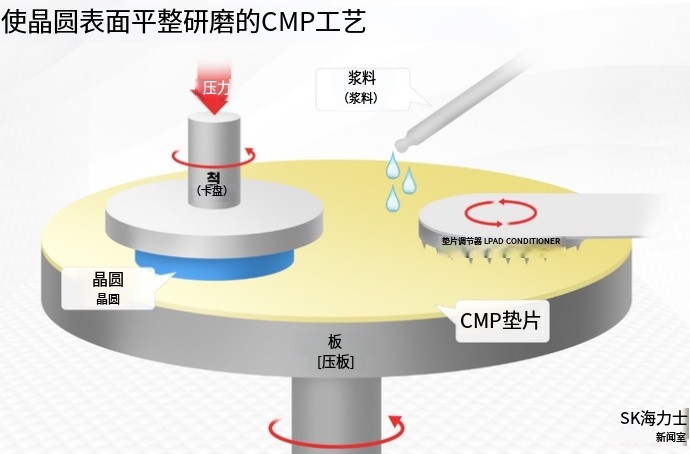
简单说:它就是半导体制造里的“磨地板神器”。
现在芯片都是多层布线(10层、20层金属很常见),每做完一层介质(氧化物或Low-k),表面都会高低不平,下一层金属填进去会出各种问题。CMP就是要把这层“地板”磨得跟镜子一样平(全局平坦度做到几纳米以内),否则后面光刻、对准、填金属全完蛋。
没有CMP,90nm以下工艺根本玩不下去,它是实现多层互连的绝对核心工艺。
二、CMP到底在磨什么?典型应用场景
STI CMP(浅沟槽隔离)
填完HDP氧化物后,把多余的氧化物磨掉,只留下沟槽里的部分,形成隔离。
聚硅栅CMP(Gate Last工艺里常用)
高K金属栅时代,常用Replacement Metal Gate,磨掉多余金属和聚硅。
ILD CMP(层间介质抛光)
每层金属前的氧化物平坦化,最常见的。
铜互连CMP(Damascene工艺核心)
最复杂、最赚钱的CMP!
电镀完厚厚一层铜后,先把凸出来的铜全部磨掉(铜清除),停在阻挡层(Ta/TaN)上;然后再把阻挡层和部分介质一起磨掉(Barrier CMP),最终形成平坦的铜线。
W-CMP(钨栓抛光
早年接触孔、Via用钨填,现在还会在某些地方用到。
新材料CMP
如Co(钴互连)、Ru(钌)、Mo(钼)、SiGe、III-V族等等,先进节点越来越多。
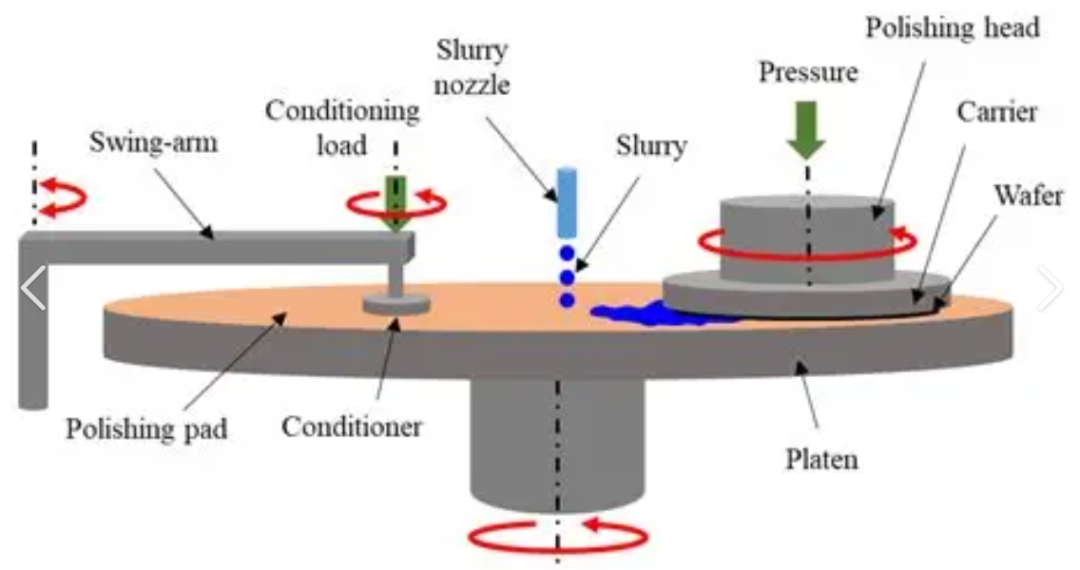
三、CMP的原理:化学 + 机械 双管齐下
别看就叫一个“抛光”,其实是化学腐蚀 + 机械磨除同时进行:
抛光液(Slurry)里含有: 氧化剂(H₂O₂最常见)→ 把铜氧化成CuO/Cu₂O,变软 纳米磨粒(SiO₂、Al₂O₃、CeO₂等)→ 机械刮除 络合剂、腐蚀抑制剂、pH调节剂 → 控制反应速度和选择比 机械部分靠: 抛光垫(Polyurethane材质,有沟槽) 旋转的抛光头(Wafer被真空吸住,倒扣在垫子上) 下压力(Down Force,通常几psi)
化学让材料变软,机械把它刮走,两者缺一不可。
只化学会腐蚀过度,只机械会严重划伤。
四、CMP设备长什么样?核心部件逐个讲
主流CMP设备:Applied Materials Reflexion LK、Ebara FREX、Lam Research等。
一台典型12英寸CMP设备结构:
1、4个抛光头(Head)
每个Head可以独立加压、转速控制,带着晶圆倒扣在垫子上旋转。
2、3~4个抛光盘(Platen)
每个盘贴一块大抛光垫,Platen 1磨铜,Platen 2磨Barrier,Platen 3清洗或Buffing。
大桶浆料 + 管路 + 喷嘴,流量要精确到ml/min。
上面镶满金刚石颗粒,实时刮抛光垫表面,防止垫子“釉化”(glazing),保持粗糙度。
电机电流检测(铜清完后摩擦力变大,电流上升) 光学干涉(激光打到晶圆上,铜和介质反射信号不同) Eddy Current(涡流传感器,铜厚实时监测,最主流)
兆声清洗 + 刷洗 + Marangoni干燥,务必把残留磨粒、浆料彻底洗干净,否则缺陷爆炸。
五、CMP最难的几个技术痛点(工艺工程师最头疼的)
大颗粒、浆料结块、修垫盘掉金刚石都会造成致命划伤。
铜线中心下陷(Dishing)、密集区介质磨太多(Erosion),导致电阻上升和可靠性问题。
铜、Ta、磨粒残留 → 短路、漏电。
铜:Barrier:TEOS的选择比要几百:几:1,否则停不住或者过磨。
中心和边缘磨除速率差要控制在几个%以内。
先进节点要求大颗粒(>0.1μm)加起来不超过几个。
六、铜CMP三步经典工艺(7nm及以上还在用)
Platen 1(Bulk Cu Remove)
高去除率浆料(>5000Å/min) 大下压力 涡流终点,留1000~2000Å铜
Platen 2(Soft Landing + Barrier Remove)
低去除率浆料 + 高选择比 小下压力,停在Barrier上不伤介质
Platen 3(Buffing + 水抛)
纯DI水或极稀浆料 去除表面微划伤和残留
七、未来趋势
极低下压力(<1psi)抛光 → 防止Low-k介质塌陷 无磨粒浆料(Abrasive-free)→ 减少划伤 新材料选择比浆料(Co、Ru、Mo) AI实时终点控制 + 机器学习优化参数 单盘多步工艺(减少设备投资)
总结一句话:CMP看起来就是“磨一磨”,其实是化学、机械、材料、设备、检测、清洗、缺陷全链条最复杂的工艺之一,良率和成本都卡在它手里。真正的CMP大神,是能在划伤、Dishing、均匀性、缺陷之间找到完美平衡的人。
免责声明:本文采摘自“老虎说芯”,本文仅代表作者个人观点,不代表公海555000JC线路检测中心及行业观点,只为转载与分享,支持保护知识产权,转载请注明原出处及作者,如有侵权请公海555000JC线路检测中心删除。







 粤公网安备44030002007346号
粤公网安备44030002007346号